蔡司高分辨X射線顯微鏡加速半導體封裝技術研發
蔡司高分辨3D X射線顯微鏡和搭載了飛秒激光系統的蔡司雙束電鏡LaserFIB聯用的方案,為封裝行業失效分析建立新的標準流程,助力國內封測企業加速開發下一代封裝技術。
半個多世紀以來半導體工藝隨著摩爾定律不斷演進到了4nm制程,先進封裝作為使芯片性能繼續提升的另一道路,吸引了國內市場的越來越多的關注和投資。
為縮短下一代封裝技術的開發周期,封裝結構內部的失效分析和缺陷表征已成為行業關注的重點。
新型封裝技術中關鍵結構的尺寸逐漸縮小,密度變高,芯片3D堆疊的層數增多,集成度也越來越高。這些因素使缺陷表征和失效分析的難度更大,周期更長,在這種情況下,3D X射線技術由于其無需破壞樣品便能觀察到內部微米級缺陷的特性在半導體封裝FA(Failure Analysis)流程里發揮著越來越重要的作用。
不破壞大尺寸樣品
怎樣定位和“看清”內部微米級缺陷?
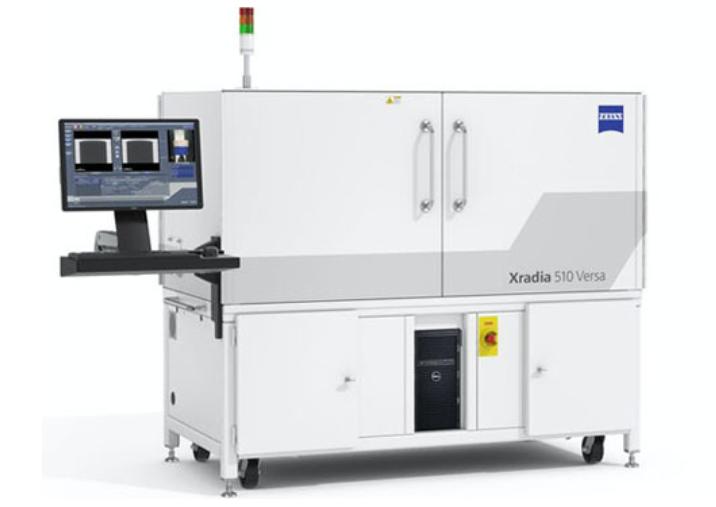
蔡司X射線顯微鏡Xradia Versa系列能檢測的典型缺陷類型包括:Microbump voids、Solder bump voids、TSV voids,seams、Microbumpshort, Head in pillow, RDL and routing shorts, Trace break and electromigration, Substrate cracks、 Solder bleed, Fatigue cracks.
當我們手握一個失效的高度集成的封裝樣品,在不破壞樣品以便用于后續分析的情況下,怎么從厘米級的大樣品中找到并看清微米級的缺陷呢?這兩者的體積相差了10^12倍。傳統的2D X射線或SAM(Scanning Acoustic Microscopy)無法檢測復雜三維結構中的微小缺陷,普通的micro CT由于分辨率隨工作距離增大而衰減,對于大尺寸樣品也是無能為力。
蔡司Xradia Versa系列高分辨3D X射線顯微鏡獨特的幾何和光學兩級放大技術,能實現大樣品大工作距離下的高分分率無損成像,輕松解決上述難題。
樣品數量太多,處理不完?
為了呈現出封裝樣品中極微小的缺陷結構,通常高通量高分辨的X射線圖像要求較長的掃描時間以保證質量,有時需要花費數小時甚至更多時間來完成FA流程中無損定位的工作,導致確定失效根源和改進方案的用時不斷延長。
如今隨著蔡司發布最新的基于深度學習的三維重構技術,在更短時間內獲得高分辨率高信噪比的圖像不再成為困難,這項獨特的重構算法可以提高最大達4倍的成像效率,快在半小時內即可獲得分析結果,重新定義了X射線顯微鏡的未來。
找到封裝內部缺陷后
工程師花幾天開封研磨樣品截面?
蔡司高分辨3D X射線顯微鏡和搭載了飛秒激光系統的蔡司雙束電鏡LaserFIB的關聯解決方案對3D封裝中深層的微凸塊結構的分析。
在有些案例中,定位并看到缺陷還不夠,需要在電鏡中做進一步分析以確定失效機理,工程師們不得不在拋光機前夜以繼日地研磨樣品。如今蔡司高分辨3D X射線顯微鏡和搭載了飛秒激光系統的蔡司雙束電鏡LaserFIB聯用的方案,為封裝行業失效分析建立新的標準流程,助力國內封測企業加速開發下一代封裝技術!
信息來源:蔡司工業質量解決方案










 掃描關注我們
掃描關注我們